7. КОНТАКТНЫЕ ЯВЛЕНИЯ
В МИКРОЭЛЕКТРОННЫХ СТРУКТУРАХ
Подавляющее большинство микроэлектронных элементов, как и дискретных полупроводниковых приборов, работает на физических свойствах контактов различных сред: контакт полупроводников p-типа и n-типа, контакт полупроводник–металл, диэлектрик–полупроводник и их более сложных комбинаций металл–диэлектрик–полупроводник (МДП), p–n–p и n–p–n и др., а также контакт полупроводника с воздушной средой. Отличительной особенностью контактных структур в микроэлектронике является их малые линейные размеры. Так, например, если переходная область контакта мощных дискретных полупроводниковых приборов имеют форму квадрата со стороной в несколько мм, то размеры контактов в интегральных схемах не превышают 0,01 мм. Кроме того, сама область контакта неоднородна. Помимо металлургического контакта, под которым подразумевают плоскость, разделяющую контактирующие среды, по обе стороны от него образуются области пространственного заряда с толщиной от 10–6 до 10–4 см и только за ними располагаются нейтральные участки контактирующих элементов, линейные размеры которых сравнимы с переходной областью. что порождает различные квантово-механические эффекты в виде туннелирования при преодолении заряженными частицами потенциального барьера, генерации «горячих» электронов и других специфических явлений. Учитывая отмеченные особенности контактов микроэлектронных структур, для изучения протекающих в них процессов целесообразно рассматривать их с помощью единого подхода, например, используя модели зонных энергетических структур дискретных полупроводниковых элементов в качестве первого приближения с последующим учетом линейных размеров изделий микроэлектроники.
7.1. Контактная разность потенциалов; работа выхода
На границе раздела двух различных по типу электропроводности твердых тел в приконтактных областях происходит перераспределение подвижных носителей зарядов, что приводит к возникновению потенциального барьера. При этом электрические свойства контактов зависят от работы выхода контактирующих областей, а также величины приложенного внешнего напряжения. Если при одной полярности приложенного напряжения сопротивление контакта увеличивается, то контакт называется «выпрямляющим», а при уменьшении сопротивления – «невыпрямляющим». На основе этих контактов формируют активные микроэлектронные компоненты, изолирующие слои и другие элементы ИС. Невыпрямляющие контакты используют в качестве омических выводов.
Величина потенциальных барьеров различных контактирующих элементов, в первую очередь, зависят от работы выхода соответствующих материалов. Однако, понятие работы выхода для полупроводников неоднозначно в силу того, что электроны могут находиться на различных энергетических уровнях. Исходя из энергетической зонной модели, среднее значение работы выхода определяется величиной энергии, необходимой для удаления электрона с уровня Ферми на нулевой уровень, т. е. в свободное состояние (рис. 7.1).

Рис. 7.1. Определение работы выхода
для полупроводников n-типа и p-типа
Таким образом, на границе контактирующих элементов возникает контактная разность потенциалов jо, определяемая разностью работ выхода (c1 – c2), а для носителей зарядов создается потенциальный барьер Еп, который в условиях равновесия равен
Епо = ejо = c1 – c2. (7.1)
7.2. Контакт двух металлов
Рассмотрим два металла с различными значениями работы выхода и энергиями уровней Ферми. Приведя их в контакт, начнется преимущественный переход электронов из металла с меньшим значением работы выхода в другой металл. Спустя некоторое время, установится равновесное состояние, поддерживаемое возникшей контактной разницей потенциалов, переход электронов прекратится, энергетические уровни Ферми расположатся на одном уровне. Результирующая разность потенциалов контактирующих двух металлов равна
jрез = e–1(Еfm1 – Еfm2), (7.2)
где Еfm1 и Еfm2 – энергетические уровни Ферми металлов.
Зонная энергетическая структура контакта двух металлов представлена на рис. 7.2.


Рис. 7.2. Зонная энергетическая структура
контакта двух металлов
В заключение отметим, что в случае контакта двух металлов при установлении равновесного состояния в области контакта образуется двойной слой объемного заряда. Однако из-за большой концентрации свободных электронов в металлах при одинаковой и неизменной температуре заметной контактной разности потенциалов не возникает.
7.3. Контакт металла с полупроводником
При контакте металла с полупроводником возможны следующие четыре варианта:
* контакт металла с полупроводником n-типа при cm > cp;
* контакт металла с полупроводником n-типа при cm < cp;
* контакт металла с полупроводником p-типа при cm > cp;
* контакт металла с полупроводником p-типа при cm < cp.
Учитывая различие работы выхода металла и полупроводника n-типа или p-типа, априори можно утверждать, что при их контакте образуется потенциальный барьер даже при отсутствии внешнего электрического поля. Высота этого барьера будет отражена величиной искривления энергетических зон.
Рассмотрим более подробно первый вариант, когда работа выхода контактирующего металла выше работы выхода для полупроводника n-типа. При контакте поток электронов из полупроводника устремится в металл и последний в приконтактной области зарядится отрицательно. Уровень Ферми в металле будет повышаться. Полупроводник из-за потери электронов в приконтактной области будет заряжаться положительно, точнее, концентрация электронов будет уменьшаться, из-за чего уровень Ферми полупроводника будет понижаться. При установлении динамического равновесия уровни Ферми металла и полупроводника выровняются. Для электронов, проникающих из полупроводника в металл, возникнет потенциальный барьер.
Епо = ejo = cm – cp. (7.3)
Приповерхностный слой полупроводника окажется обедненным на глубину dn от контакта. Глубина проникновения контактного поля тем глубже, чем больше разность работ выхода и чем меньше концентрация легирующей примеси в полупроводнике.
dn = (2eeо Епо / noe)1 / 2. (7.4)
Следует отметить, что проникновение контактного поля в металл будет намного меньше dn из-за различия концентрации носителей в металле и полупроводнике.
Возникновение внутреннего электрического поля в контактной области приведет к искривлению энергетических зон, в данном случае вверх, так как для преодоления потенциального барьера электрону потребуется дополнительная энергия. Изменение величины контактного потенциала от границы контакта будет происходить по закону
j = jo.exp(– x / Ld), . (7.5)
а концентрация электронов в возмущенной области
n(x) = no. exp(– Eп(x) / kT). (7.6)
Легко показать, что в случае, когда cm <cp, концентрация электронов в приконтактной области увеличится за счет перехода электронов из металла в полупроводник. Этот случай называется обогащением приконтактной области.
Зонные энергетические диаграммы для всех упомянутых выше четырех случаев контакта металла с полупроводником n-типа и p-типа приведены на рис. 7.3.
Образовавшиеся в месте контакта металла с полупроводником области обеднения и обогащения носителями зарядов, так же, как и p–n-переход, будут обладать свойствами выпрямляющих и омических контактов. Отмеченное свойство контакта металл–полупроводник имеет существенное значение при металлизации интегральных схем и создании омических контактов.
Если толщина слоя dp > Ld,то движение носителей зарядов в нем подчиняется законам диффузии, что характерно для слаболегированных полупроводников. Для сильнолегированных полупроводников, когда dp < Ld, ток в контакте похож на ток в полупроводниковом диоде при небольшом потенциале на аноде. Электроны преодолевают слой против поля без столкновений. Теория тонких запирающих слоев называется «диодной теорией», а запирающие слои – барьерами Шотки. Критериями указанных различий являются соотношения:
kTdp / 2ejol >> 1 (диффузионная теория), (7.7)
kTdp / 2ejol < 1 (диодная теория), (7.8)
где dp – толщина обедненного слоя, l – длина свободного пробега, jo – контактная разность потенциалов.
а

б

Рис. 7.3. Зонные энергетические структуры контакта металла с полупроводником:
а – обеднение (запирающий контакт); б – обогащение (антизапирающий контакт)
7.4. Барьер Шотки
Барьер Шотки возникает при контакте металла с сильно легированным полупроводником n-типа. Контакт металл–полупроводник может быть как омическим, так и выпрямляющим. В выпрямляющем контакте, который называют диодом Шоттки, cm > cp и электропроводность обусловлена основными носителями зарядов. В нем, по сравнению с обычным диодом, более высокая скорость переходных процессов, низкое напряжение отпирания, более крутая вольтамперная характеристика в положительной области. Структура диода Шотки, его условное обозначение и вольт-амперная характеристика представлены на рис. 7.4.

Рис. 7.4. Диод Шотки
Заметим, что в обычном диоде на p–n-переходе, в отличие от диодов Шотки, скорость переходных процессов ниже, так как ток создается движением неосновных носителей. В нем выше напряжение отпирания: 0,6 В против 0,3 В для диодов Шотки.
7.5. Омические контакты
В микроэлектронике большое значение придается созданию омических контактов с малым контактным сопротивлением. Исходя из вышеизложенного (раздел 7.3), омические контакты образуются при контакте металла с полупроводником, для которого работа выхода металла ниже работы выхода полупроводника n-типа и выше для полупроводника p-типа. В частности, при алюминиевой металлизации на кремнии широко применяется контакт Al–n+, который, кроме малого сопротивления, предотвращает акцепторное легирование приконтактной области полупроводника.
В последнее время хорошие омические контакты создаются при контакте силицидов тугоплавких металлов с кремнием при последующем высокотемпературном отжиге.
7.6. Контакт двух полупроводников одинакового
типа проводимости (n–n+ и p–p+)
В контакте двух полупроводников одного типа проводимости, но различной степени легирования (n–n+ и p–p+), как и для обычных p–n-переходов, высота потенциального барьера определяется концентрацией основных носителей заряда. Однако в данном случае не образуется слой с малой концентрацией заряда. Поэтому сопротивление структуры определяется ее высокоомной областью. В таком контакте происходит диффузионный перенос зарядов и не образуется двойной слой, а реализуется лишь плавный переход от n к n+, отсутствует инжекция неосновных носителей заряда. После установления равновесного состояния уровни Ферми выравниваются. Контакт всегда омический. Энергетическая зонная структура такого контакта представлена на рис. 7.5.
Аналогичные характеристики имеет контакт p–p+-типа.


Рис. 7.5. Зонная энергетическая структура контакта полупроводников одинакового типа проводимости
7.7. Контакт полупроводника с атмосферой;
эффект поля; поверхностные состояния
В ограниченных по размерам полупроводниковых кристаллах часто происходит появление на поверхности положительного или отрицательного заряда, например, прилипание электронов на оборванных ковалентных связях поверхностных атомов, загрязнение поверхности в технологическом цикле и т. п., характеризуемые как поверхностные состояния. В соответствии с условием электрической нейтральности это явление должно сопровождаться возникновением в приповерхностном слое объемного заряда противоположного знака, нейтрализующего поверхностный заряд. В результате приповерхностный слой полупроводника оказывается обедненным носителями заряда одного знака с поверхностным зарядом и обогащенным носителями заряда противоположного знака. Аналогичная картина происходит и под действием электрического поля и носит название «эффекта поля». Это отчетливо иллюстрируется рис. 7.6, на котором изображена структура: полупроводник и не контактирующая с ним отрицательно заряженная металлическая пластинка.
Область объемного заряда у поверхности полупроводника распространяется на так называемую «дебаевскую» длину экранирования

Рис. 7.6. Кривая распределения потенциала
при воздействии отрицательного заряда
на полупроводник p-типа
Ld, определяемую как расстояние, на протяжении которого потенциал поля уменьшается в «e» раз.
Ld = (eeоkT / 2e2ni)1 / 2 =(eeоUT / 2e2ni)1 / 2. (7.9)
Для примесных полупроводников при N >> ni
Ld = (eeоUT / 2e2N)1 / 2. (7.10)
В качестве примера отметим, что для собственного полупроводника кремния Ld = 14 мкм, а для примесного N = 1022 см–3, Ld = 0,04 мкм при Т = 300 К.
Концентрация электронов и дырок в приповерхностном слое описывается выражениями
n = ni.exp[(Еf – Еi) / kT], (7.11)
p = ni.exp[(Еi – Еf) / kT]. (7.12)
Из формул (7.11) и (7.12) следует, что если Ef > Ei, (уровень Ферми расположен выше середины запрещенной зоны), то (Ef – Ei) > > 0, n > ni > p, и полупроводник в приповерхностной зоне обладает электронной проводимостью независимо от типа собственной проводимости. Если Ef < Ei, то (E – Ei) < 0, n < ni < p, и полупроводник обладает дырочной проводимостью. При Ef = Ei полупроводник ведет себя как собственный.
Таким образом, в приповерхностной зоне полупроводника могут наблюдаться следующие процессы: обеднение, обогащение и инверсия носителей заряда. Обеднение наступает в том случае, когда на поверхности полупроводника появляется заряд, совпадающий по знаку с основными носителями заряда. В этом случае поверхностный заряд как бы отталкивает в приповерхностном слое заряды однотипного знака. Обогащение наступает в случае, когда знак поверхностного заряда противоположен знаку основных носителей заряда в полупроводнике. Под влиянием заряда поверхности происходит притяжение к ней заряда противоположного знака и обогащение ими приповерхностного слоя. Если к поверхности полупроводника n-типа приложен очень большой потенциал (или заряд) отрицательной полярности, или к полупроводнику p-типа положительной полярности, то в приповерхностной области образуется так называемый инверсный слой с проводимостью противоположной основной (рис. 7.7).

Обеднение

Обогащение

Инверсия
Рис. 7.7. «Эффект поля» для полупроводника n-типа и p-типа при различных зарядах на поверхности
Появление заряда на поверхности полупроводника вызывает искривление энергетических зон вследствие возникновения разности потенциалов между поверхностью и объемом на глубину Ld. При заряжении поверхности отрицательным зарядом энергетические зоны искривляются вверх, т. к. при перемещении электрона из объема к поверхности его энергия увеличивается. При заряжении поверхности положительным зарядом энергетические зоны искривляются вниз. В инверсном слое кривая, соответствующая середине запрещенной зоны, пересекает уровень Ферми и располагается выше его в полупроводнике n-типа и ниже в p-типа.
На явлении «эффекта поля», рассмотренного выше, работают полевые транзисторы и МОП структуры микроэлектроники. Учитывая планарную структуру интегральных схем, эффект поля может проявиться самопроизвольно, т. е. без специально приложенного внешнего электрического потенциала, а за счет появления зарядов на поверхности. Это явление может оказывать существенное влияние на работу и параметры ИС.
Одна из основных причин возникновения поверхностных состояний заключается в обрыве периодического потенциала на поверхности кристалла. При этом атомы, расположенные на поверхности полупроводника, ведут себя как акцепторы в связи с появлением нескомпенсированных валентных связей (рис. 7.8).
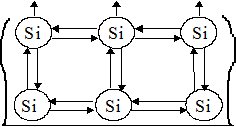
Рис. 7.8. Образование нескомпенсированных
валентных связей на поверхности кристалла кремния
Это означает, что такие атомы способны принимать дополнительные электроны на свою внешнюю оболочку. Следовательно, в полупроводнике возникают дополнительные квантовые состояния, в которых электроны локализованы непосредственно на самой поверхности кристалла. Таким образом, кроме объемных энергетических уровней, образующих соответствующие зоны неограниченного по протяженности кристалла, появляются дополнительные локальные уровни, расположенные в запрещенной зоне. Эти уровни могут заполняться электронами путем «прилипания» их на поверхности и создавать поверхностный электрический заряд, приводящий к появлению эффекта поля.
Благодаря поверхностным состояниям, может появиться возможность перемещения зарядов вдоль поверхности, что создает поверхностную проводимость.
Кроме обрыва валентных связей, дополнительной причиной появления поверхностных состояний могут быть любые дефекты поверхности, возникающие при выполнении различных технологических операций.
В реальных условиях на поверхности полупроводника одновременно могут существовать как донорные, так и акцепторные уровни поверхностных состояний, что может привести к частичной компенсации поверхностного эффекта поля (рис. 7.9).

Рис. 7.9. Зонная структура полупроводника
n-типа с учетом поверхностных состояний:
Еб – энергетический уровень быстрых поверхностных состояний; Еа и Ед – акцепторные и донорные уровни медленных поверхностных состояний
Поскольку глубина проникновения поля поверхностных состояний сравнима с размерами элементов современных интегральных схем, то становится очевидной отрицательная роль этого явления в нормальном функционировании изделий микроэлектроники. Так например, искривление энергетических зон под воздействием поля поверхностного заряда может привести к образованию вблизи поверхности полупроводника тонкого инверсного слоя толщиной от 0,01 до 1 мкм, электропроводность которого будет противоположной проводимости в объеме, что аналогично появлению паразитного МОП элемента. Особую опасность представляют положительные ионы натрия, способствующие образованию инверсного слоя в кремнии p-типа.
Поверхностные состояния могут быть двух типов: быстрые, характеризующиеся малым временем рекомбинации, и медленные с довольно большим временем рекомбинации. Быстрые поверхностные состояния фиксируются на границе кремния с диоксидом или нитридом кремния, которые используются для защиты поверхности, а медленные – на поверхности диэлектрика. Кроме того, часть поверхностных состояний могут располагаться внутри оксидного слоя.
8. АКТИВНЫЕ И ПАССИВНЫЕ
ЭЛЕМЕНТЫ МИКРОЭЛЕКТРОНИКИ
Подавляющее большинство электронных систем как в дискретном, так и в интегральном исполнении функционирует на закономерностях процесса переноса зарядов (электронов и дырок) в различного рода контактах, рассмотренных в предыдущей главе. Современная интегральная схема содержит огромное количество таких контактов в составе активных и пассивных элементов, объединенных в единую схему, выполняющую определенную функцию в процессе обработки информации. При этом следует отметить, что с позиции физики нет принципиальной разницы между дискретными элементами полупроводниковой электроники и их аналогами в интегральном исполнении. В обоих случаях работа активных элементов (диодов, биполярных и полевых транзисторов) базируется на контактах статических неоднородностей величины и типа проводимости контактирующих материалов. В основном это полупроводниковые материалы с областями локального легирования, в приконтактных областях которых образуются объемные заряды и градиент их концентрации, порождающие внутреннее электрическое поле, под действием которого происходит диффузионное и дрейфовое перемещение зарядов. Управлять этими процессами можно с помощью внешнего потенциала, не устраняя при этом первоначально созданную неоднородность проводимости.
Однако, несмотря на идентичность функционирования, структура и технология изготовления интегральных активных и пассивных элементов существенно отличается от таковых для дискретных элементов. Одним из таковых отличий являются чрезвычайно малые линейные размеры микроэлементов, сравнимые с длиной дебаевского экранирования и другими характерными величинами, что может стать причиной появления размерных квантово-механических эффектов в виде туннелирования. Это, в свою очередь, может создать непреодолимый барьер в миниатюризации.
Кроме того, в микроэлектронных системах чрезвычайно велико взаимное влияние рядом расположенных структур, создающих так называемые паразитные активные и пассивные элементы и нежелательные каналы перемещения зарядов.
Для системного изложения материала необходимо вначале кратко остановиться на хорошо известных физических принципах функционирования дискретных p–n-переходов, а затем перейти к рассмотрению более сложных структур на их основе в интегральном исполнении.
8.1. Физические явления в p–n-переходе; интегральные диоды
Электронно-дырочным переходом (сокращенно p–n-переходом) называется контакт двух областей одного и того же полупроводника с различным типом проводимости: электронной (n) и дырочной (p). Если оба контактирующие полупроводника легированы соответственно донорной и акцепторной примесью в одинаковой степени, то такой p–n-переход называется симметричным. Различают плавный и резкий p–n-переходы, в последнем концентрация донорной и акцепторной примеси изменяется скачком. Наличие градиентов концентрации электронов и дырок по обе стороны от металлургической границы контакта порождает диффузионное перемещение подвижных носителей зарядов: электронов из n-области в p-область и дырок в противоположном направлении. По этой причине в приконтактных областях возникают объемные заряды, характеризующиеся контактным потенциалом, появление которого обусловлено разноименно заряженными неподвижными атомами донорной и акцепторной примесей. Диффузионное перемещение зарядов прекратится тогда, когда контактный потенциал уравновесит разность работ выхода электронов и дырок в полупроводнике n-типа и p-типа. В то же время в области объемного заряда возникнет внутреннее электрическое поле, порождающее дрейфовое движение неосновных носителей заряда. В условиях термодинамического равновесия диффузионный ток уравновешивается встречным дрейфовым. Следовательно, суммарный ток через p–n-переход окажется равным нулю:
J = JD + JE = e[ Dn(dn / dx) – Dp(dp / dx)] = 0. (8.1)
Из равенства нулю суммарного тока следует, что контактирующие полупроводники должны характеризоваться одинаковым положением уровней Ферми в n-области и в p-области.
Таким образом, в приконтактной области создается запирающий слой из-за обеднения подвижными носителями зарядов, в результате чего его удельное сопротивление существенно увеличивается. Высота потенциального барьера определяется разностью положения уровней Ферми Efn – Efp.
Зонная энергетическая структура симметричного p–n-перехода в условиях термодинамического равновесия представлена на рис. 8.1, где указаны направления движения подвижных заряженных частиц в области контакта, создающих диффузионные и дрейфовые составляющие плотности электрического тока.

|
Из за большого объема этот материал размещен на нескольких страницах:
1 2 3 4 5 6 7 8 9 10 11 12 |




