Метод | Физический параметр | Контролируемый параметр | Краткая характеристика метода |
Просвечивающая электронная микроскопия (ПЭМ, TEM) | Распределение коэффициента поглощения проникающих электронов | Изучение структуры тонкопленочных образцов | Выявление дефектов тонких пленок |
Электроногра-фия на просвет (ЭНП, ТЕD) | Дифракция электронов | Изучение кристаллической структуры пленок | Выявление дефектов структуры тонких пленок |
Рентгеновские методы (RBS), (РД, XRD), (РМА, XES) | Дифракция и обратное рассеяние рентгеновских лучей | Химический состав материалов | Контроль химического состава материалов |
Масс-спектро-метрический метод (MS) | Масс-спектры газоплазменной среды | Компонентный состав плазменной среды | Метод высокоточ-ный, однако сложный в реализации |
Оптические методы | |||
Метод эмиссионной спектроскопии (ЭС, ES) | Спектр собственного излучения плазмы | Кинетика процессов плазменного травления или нанесения, определение момента окончания травления | Метод косвенный, бесконтактный, интегральный, весьма информативный, прост в реализации, широко используется в микроэлектронике |
Метод ИК абсорбционной спектроскопии (ИКС, IRS) | Спектр поглощения в ИК области | Компонентный состав и структура материалов и газов | Определение момента окончания процесса травления. Сложный в реализации |
Оптическая микроскопия | Визуальное изучение поверхности | Состояние и морфология поверхности | Метод визуального определения качества поверхности |
Лазерные методы (LR) а) Лазерное отражение б) Интерферо-метрический | Коэффициент отражения Интерференция | Определение момента окончания процесса плазменного травления | Метод сложен в реализации и находит ограниченное применение |
Комбинацион-ное рассеяние света (КРС, RS) | Спектр комбинационного рассеяния света (спектр Рамана) | Анализ состава и структуры поверхностного слоя | Широко применяется для анализа тонких поверхностных слоев |
Перечисленные в табл. 10.1 диагностические методы позволяют изучать и контролировать морфологию поверхности, проводить химический и кристаллографический анализ материалов, ход плазменного технологического процесса нанесения и травления тонкопленочных структур и фиксировать момент окончания процесса травления. Рассмотрим более подробно эти возможности.
10.2.1. Исследование морфологии поверхности
Суть заключается в визуальном или приборном исследовании геометрических параметров элементов, а именно: резкость границ топологического рисунка, точность совмещения, расстояние между элементами, наличие дефектов в виде разрывов или коротких замыканий элементов топологической структуры и т. д. Контроль проводится методами оптической микроскопии, а также растровой и просвечивающей электронной микроскопии. Для исследования неровностей по высоте различных элементов может быть использован лазерный метод или оптическая микроскопия в режиме интерференционного контраста. Учитывая, что предел разрешения невооруженного глаза составляет 0,1 мм, а оптического микроскопа порядка 0,25 мкм, то необходимое увеличение должно составлять 1000 – 2000.
Более высоким пространственным разрешением и глубиной резкости обладает растровая электронная микроскопия: до 10 нм по ширине и 2 – 4 мкм по глубине. Следует отметить, что при анализе этим методом поверхности диэлектрических материалов возможно появление радиационных дефектов, поверхностных зарядовых состояний и ловушек на границе раздела SiO2 и Si. Радиационные дефекты устраняются последующим отжигом при температуре 400 – 500 оС, а отвод поверхностных зарядов можно осуществить путем покрытия поверхности тонкой металлической пленкой (10 нм).
Еще большее пространственное разрешение, порядка 0,2 нм, можно получить, применяя просвечивающую электронную микроскопию. При этом толщина исследуемых образцов должна обеспечивать «прозрачность» для электронов с энергией 60 – 350 кэВ. Предел толщины исследуемых кремниевых пленок 0,5 – 1,5 мкм.
Контраст изображения зависит от кристаллической или аморфной структуры образца. При исследовании кристаллических образцов первичный электронный пучок дифрагирует на кристаллической решетке, что увеличивает контраст изображения. В случае аморфных пленок контраст изображения определяется различного рода локальными неоднородностями пленки по толщине, изменениями фазового состояния и др.
10.2.2. Химический анализ
Диагностические методы химического анализа образцов позволяют определять распределение примеси как по плоскости поверхности, так и по глубине с чувствительностью в пределах от 1011 до 1021 см–3 , т. к. в этих пределах проводится степень легирования полупроводников. Анализ концентрации примеси можно осуществить с помощью электронной оже-спектроскопии, спектроскопии обратного рассеяния Резерфорда, растровой и просвечивающей электронной микроскопии, масс-спектроскопии вторичных ионов.
Метод электронной оже-спектроскопии основан на анализе энергии оже-электронов, которые генерируются в результате ионизации внутренних электронных оболочек атомов Поскольку энергия первичных электронов лежит в пределах от 2 до 10 кэВ, то глубина их проникновения составляет порядка 5 нм. Энергия вторичных оже-электронов при этом составляет 20 – 2000 эВ. Поэтому, метод оже-спектроскопии позволяет анализировать химический состав приповерхностной области. Для анализа концентрации по глубине применяют послойное ионное стравливание образца ионным пучком инертного газа. Предел чувствительности метода 1017 см–3.
Химический анализ образцов методом спектроскопии обратного рассеяния Резерфорда основан на анализе энергии обратно рассеянных ионов инертного газа (He) по отношению к энергии первичных ионов (1 – 3 МэВ). По графику зависимости количества обратно рассеянных ионов от их энергии однозначно определяют химический состав образца. Чувствительность метода составляет 1018 см–3.
Для химического анализа образцов могут быть использованы различные рентгеновские методы: рентгеновский микроанализ, рентгеновский флуоресцентный анализ, рентгеновская фотоэлектронная спектроскопия. Рентгеновские методы могут применяться в сочетании с электронными растровым и просвечивающим методами. Растровый или просвечивающий электронные пучки используются для генерации рентгеновского излучения, характерные линии которого несут информацию о химическом составе образца.
Для анализа химического и компонентного состава газовых сред, например, в плазменной технологии нанесения методом магнетронного распыления и плазменного травления в плазме ВЧ разряда низкого давления тонких проводящих, полупроводниковых и диэлектрических слоев можно использовать методы эмиссионной и абсорбционной ИК спектроскопии, а также метод масс-спектрометрии.
В случае эмиссионной спектроскопии анализируется эмиссионный спектр собственного излучения плазмы, в ИК абсорбционной спектроскопии – спектр поглощения в ИК области, а при масс-спектроскопическом анализе регистрируются по массе ионные компоненты распыляемого твердого образца или ионизованные атомы и молекулы газовой среды. Анализ проводится в «магнитной призме» квадрупольного анализатора. В сочетании с послойным ионно-плазменным стравливанием, метод масс-спектроскопии позволяет проводить химический анализ по глубине образца. Чувствительность метода составляет 1013 см–3.
10.2.3. Кристаллографический анализ
Сущность используемых методов заключается в определении кристаллической структуры полупроводниковых материалов: определение типа и размеров кристаллической решетки и ее ориентации по отношению к поверхности, размеров кристаллических зерен, выявление аморфных областей и других дефектов кристаллической структуры. Кристаллическая структура может быть расшифрована методами: обратного рассеяния Резерфорда, рентгеновской дифракции, электронографии на просвет и просвечивающей электронной микроскопии.
10.3. Оперативный контроль в микроэлектронике;
определение момента окончания технологического процесса
Непрерывный прогресс в современной микроэлектронике требует совершенствования методов контроля. Многостадийность процесса изготовления ИМС и широкое внедрение вакуумно-плазменных технологий не удовлетворяет существующий послеоперационный контроль и требует перехода на контроль параметров в процессе проведения самой операции, т. е. на оперативный контроль за ходом каждого технологического процесса и определения момента окончания каждого из них с выдачей команды на смену операции. При этом оперативный контроль должен автоматически поддерживать заданные параметры и программу их изменения.
Для реализации автоматического оперативного контроля можно использовать многие из перечисленных в табл. 10.1 методов контроля, в основу которых положено изменение во времени одного из физических параметров: спектра излучения или поглощения плазменной среды, коэффициента отражения лазерного луча от поверхности, сопротивления стравливаемого образца и других величин в зависимости от скорости травления или нанесения тонких слоев с учетом компонентного состава распыляемого или наносимого слоя.
С учетом информативности, бесконтактности, простоты в реализации, стоимости и возможности автоматизации для решения поставленной задачи вне конкуренции находится метод эмиссионной спектроскопии, что и обеспечивает ему широкое внедрение в промышленности. Сущность этого метода заключается в регистрации изменения во времени собственного излучения плазмы, в частности, относительной интенсивности характерных спектральных линий атомов и молекулярных полос, адекватно отражающих ход технологического процесса и позволяющих фиксировать момент окончания процесса.
Метод эмиссионного спектрального анализа, хотя и уступает масс-спектрометрическому по точности определения концентрации продуктов реакции, но превосходит его по быстродействию, простоте реализации и значительно ниже по стоимости. Он позволяет получать информацию о пространственном и временном распределении измеряемых параметров, точно поддерживать необходимый состав плазмы и однозначно фиксировать момент окончания процесса.
Самым ответственным моментом в реализации данного метода является выбор характерных спектральных линий и полос. Этот процесс должен быть индивидуальным для каждого технологического процесса. Обычно выбираются линии реактивных элементов газовых сред, например, фтора при плазменном травлении кремнийсодержащих структур; элементов распыляемых мишеней при нанесении пленок; частиц, принадлежащих конечным продуктам реакции, например алюминия при травлении металлизации, СО при деструкции фоторезиста, N2 при травлении Si3N4.
Один из фрагментов, используемых участков спектра, в частности, при плазменном удалении фоторезиста полиимида и др. слоев, представлен на рис. 10.1.
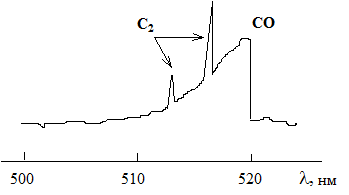
Рис. 10.1. Участок спектра, используемый для контроля плазменного удаления пленки фоторезиста в кислороде
Молекулярные полосы С2 и СО на участке спектра от 512 до 520 нм являются излучением соответствующих продуктов реакции.
Рекомендуемые спектральные линии должны одновременно обеспечивать фиксацию момента окончания травления, в основе которого лежит резкое изменение интенсивности сигнала вплоть до нулевого значения или до уровня фона в момент завершения травления или перехода границы двух слоев, что имеет место при травлении SiO2 на Si. Это необходимо для исключения возможного перетрава и повреждения ниже лежащих структур.
Типичное изменение относительной интенсивности спектральной линии или молекулярной полосы на примере контроля процесса удаления фоторезиста представлено на рис. 10.2.
Стрелкой отмечен момент окончания процесса, когда интенсивность полосы выходит на уровень фона.
Соответствующая функциональная схема одноканального прибора спектрального контроля представлена на рис. 10.3.
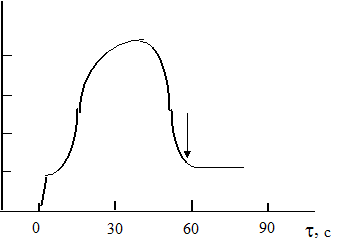
Рис. 10.2. Изменение интенсивности молекулярной полосы СО (519,8 нм) при плазменном удалении пленки фоторезиста

Рис. 10.3.Функциональная схема одноканального прибора спектрального контроля:
1 – реактивная камера травления; 2 – оптический фильтр; 3 – преобразователь
оптического сигнала в электрический; 4 – усилитель; 5 – регистратор
Вывод оптического сигнала из плазменной реакционной камеры осуществляется с помощью световода, что позволяет сам прибор контроля размещать вне плазменной установки. Для выделения характерного участка спектра может быть использован светофильтр или монохроматор. Преобразование оптического сигнала в электрический осуществляется с помощью фотодиода или фототранзистора с одновременным усилением сигнала. На выходе сигнал контроля регистрируется самописцем или любым другим способом, позволяющим использовать его для автоматической коррекции параметров технологического процесса введением отрицательной обратной связи или формированием команды на смену программы после завершения данного технологического процесса.
Для устранения возможной нестабильности параметров плазмы в реакционной камере и исключения влияния фонового излучения используется двухканальная система контроля, в которой, кроме аналитического сигнала, одновременно регистрируется опорный сигнал, автоматически вычитаемый на выходе из суммарного сигнала контроля. Функциональная схема двухканального прибора спектрального контроля приведена на рис. 10.4.

Рис. 10.4. Функциональная схема двухканального прибора спектрального контроля:
1 – реактивная камера травления; 2 – оптический фильтр; 3 – преобразователь
оптического сигнала в электрический; 4 – усилитель; 5 – регистратор
Оптические сигналы для аналитического и опорного каналов одновременно выводятся из реакционной камеры с помощью световодов и одновременно обрабатываются. В выходном устройстве регистрируется их разность или отношение. Алгоритм обработки сигналов управляющим микропроцессорным контроллером диктуется спецификой конкретного технологического процесса.
В сложных технологических процессах, например при нанесении многокомпонентных слоев с использованием нескольких реактивных газов при магнетронном распылении одной или нескольких мишеней, используются многоканальные системы спектрального контроля и управления.
Одним из достоинств технологических процессов с применением систем спектрального контроля и автоматического управления является воспроизводимость оптимальных параметров изготавливаемых изделий.
Рекомендуемые параметры для оперативного контроля и управления некоторыми плазменными технологическими процессами приведены в табл. 10.2.

Таблица 10.2
Рекомендуемые параметры для оперативного спектрального контроля плазменных технологических процессов.
Техно-логи-ческий процесс | Плаз-мооб-разу-ющий газ | Продукты реакции | Наблюдаемые молекулярные полосы и атомные линии, нм | Рекомен-дуемые для контроля участки спектра |
Плаз-менное удале-ние фото-резис-та | О2 О2 + N2 | СО, C2, CN, CH, ОН, Н, СО2, Н2О, N2, H2 | С2 – система Свана; С – наиболее яркая линия 247,9; СО – система Ангстрема, 5В, 3+; СН – система 430; CN – главная серия фиолетовой системы, красная система ОН – система 306,4 Н – серия Бальмера (Нa, Нb, Нg); О – наиболее яркие: 436,8; 615,7; 645,5; 700,2; 777; N2 – 1+ и 2+ системы N2+ – 1– система | CO 520 нм |
Плаз-менное трав-ление Si, SiO2, Si3N4 | CF4 CF4+O2 CCl4 SF6 CF2Cl2 и др. | SiF4, SiCl4, SiFx, SiClx, CO, CO2, CN, N2 и др. | F; SiF – a и g системы; SiO2 – плотная группа полос разного вида в области 421 – 430 нм; SiO – 8 полос в фиол. области; CN – главная серия фиолетовой системы; CO – системы: 3+, 5В, Ангстрема; СН – система 430; С2 – система Свана; N2 – 1+ и 2+ системы; NO – a и g системы; ОН – система 306,4; Н – Нa, Нb и др.; Cl – 247,8; F – 685,6, 703,7 и др.; | F 703,7 нм, SiF 435 – 445 нм, СО 520 нм, N2 390 нм |
Окончание табл. 10.2

|
Из за большого объема этот материал размещен на нескольких страницах:
1 2 3 4 5 6 7 8 9 10 11 12 |




